İleriye dönük: Büyük çip üreticisi şirketler, bir süredir farklı türde silikon bileşenleri üst üste yığmaya çalışıyor. Görünüşe göre Samsung, mantık çiplerini yüksek bant genişliğine sahip RAM ile birleştiren önemli bir gelişmeyi piyasaya sürmeye hazır görünüyor.
Samsung, Samsung Foundry Forum 2024 etkinliği sırasında en yeni ve en gelişmiş çip paketleme teknolojisini ve hizmet yol haritasını tanıttı. Korea Economy Daily’nin aktardığı isimsiz sektör kaynaklarına ve Samsung’un kendi açıklamalarına göre, yeni teknoloji 2025’te dördüncü nesil yüksek bant genişlikli bellekle piyasaya çıkacak.
Samsung’un yeni istifleme çözümü çip tasarımında önemli bir ilerlemeyi temsil ediyor. Bu, dünyanın en büyük bellek üreticisi tarafından resmi olarak tanıtılan ilk 3D paketleme teknolojisidir ve bu kadar gelişmiş çipleri üretmek için gereken uzmanlığa ve araçlara sahip az sayıda şirketten biridir. Mevcut yığınlama teknolojileri, HBM bellek yongasının bir silikon aracı aracılığıyla alttaki mantık yongasına (çoğunlukla GPU’lar) yatay olarak bağlandığı “2.5D” tasarımına dayanmaktadır.
Samsung tarafından geliştirilen 3D paketleme teknolojisi, görünüşte bir aracıya olan ihtiyacı ortadan kaldırarak, bellek yongası ile mantıksal silikon bileşenler arasında “gerçek” dikey istiflemeyi mümkün kılıyor. Bununla birlikte, 3 boyutlu bir ambalaj tasarımı oluşturmak, HBM belleği için yeni bir temel kalıp gerektirir ve bu da denklemin içine çok daha karmaşık bir süreç teknolojisi katar.
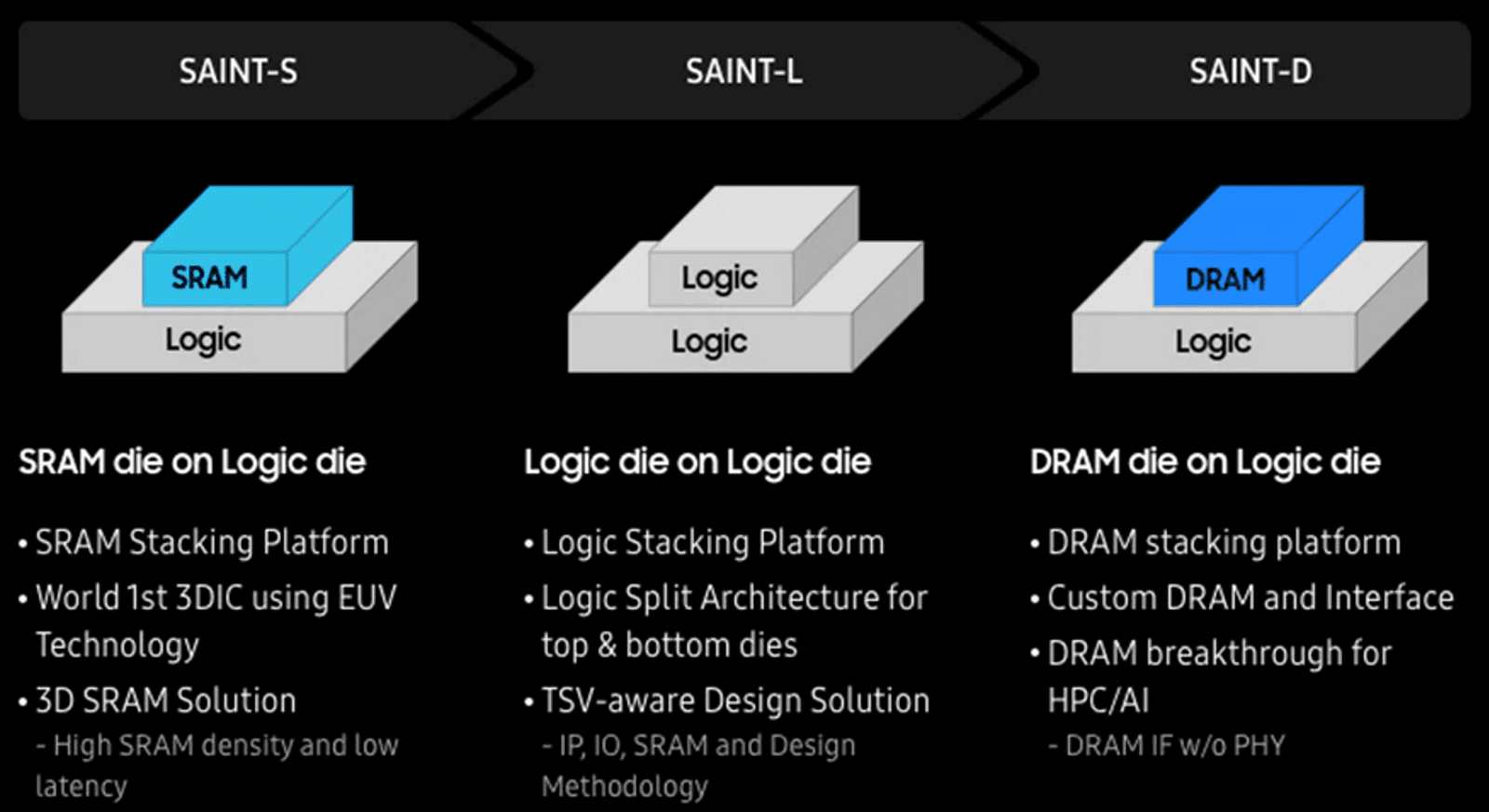
Samsung’un 3D paketleme çözümü SAINT veya Samsung Gelişmiş Ara Bağlantı Teknolojisi olarak bilinen bir platforma dayanmaktadır. Teknoloji yıllardır geliştiriliyor ve farklı silikon türleri için farklı yaklaşımlar içeriyor. SAINT-S çözümü, mantıksal kalıp istiflemede SRAM kalıbı içindir, SAINT-L, mantıksal kalıp istiflemede mantıksal kalıp içindir ve SAINT-D, mantıksal kalıp istiflemede DRAM kalıbı içindir.
// İlgili Öyküler
- Yeni Samsung 2nm yol haritası, 2027’de arkadan güç dağıtımının geleceğini gösteriyor
- PCIe 7.0, optik bağlantı gösteriminde etkileyici 128 GT/s’ye ulaştı
3D paketleme sayesinde gelecekteki GPU’lar daha hızlı veri aktarım hızları, daha temiz elektrik sinyalleri, daha az güç tüketimi ve daha düşük gecikme seviyeleri sağlayacak. Bununla birlikte, 3D paketleme çözümleri de daha yüksek maliyetlere sahip olacak ve görünüşe göre Samsung, ilgilenen müşterilere daha fazla HBM çipi satmak için bunları “anahtar teslimi” bir hizmet olarak sunmakla ilgileniyor.
Koreli şirketin SAINT-D sürecini bu yıl tamamlaması ve HBM4 bellek teknolojisinin gelecek yıl gelmesi bekleniyor. Korea Daily’ye göre, başta Nvidia olmak üzere yapay zeka hızlandırıcıları geliştiren şirketler, Samsung’un yeni teknolojiye yönelik ana iş hedefleri arasında yer alıyor. Ancak SAINT-D, bilinen hiçbir şirketin şu anda üzerinde çalışmadığı bir çip yeniden tasarım çalışması gerektirecek.
